Maombi katika Sekta ya Semiconductor
GREEN ni Biashara ya Kitaifa ya Teknolojia ya Juu inayojitolea kwa R&D na utengenezaji wa unganisho la kielektroniki la kiotomatiki na vifaa vya ufungashaji vya semiconductor na kupima. Kuhudumia viongozi wa tasnia kama vile BYD, Foxconn, TDK, SMIC, Solar ya Kanada, Midea, na biashara zingine 20+ za Fortune Global 500. Mshirika wako unayemwamini kwa suluhu za juu za utengenezaji.
Mashine za kuunganisha huwezesha viunganisho vidogo na vipenyo vya waya, kuhakikisha uadilifu wa ishara; soldering ya utupu wa asidi ya fomu huunda viungo vya kuaminika chini ya maudhui ya oksijeni <10ppm, kuzuia kushindwa kwa oxidation katika ufungaji wa juu-wiani; AOI huzuia kasoro za kiwango cha mikroni. Harambee hii inahakikisha > 99.95% ya mavuno ya juu ya ufungaji, kukidhi mahitaji makubwa ya majaribio ya chip za 5G/AI.

Ultrasonic Wire Bonder
Ina uwezo wa kuunganisha waya wa alumini 100 μm-500 μm, waya wa shaba 200 μm-500 μm, ribbons za alumini hadi 2000 μm kwa upana na 300 μm nene, pamoja na ribbons za shaba.
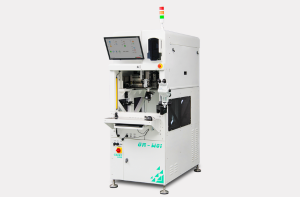
Masafa ya usafiri: 300 mm × 300 mm, 300 mm × 800 mm (inaweza kubinafsishwa), yenye uwezo wa kujirudia <±3 μm

Masafa ya usafiri: 100 mm × 100 mm, yenye uwezo wa kurudia <±3 μm
Teknolojia ya Kuunganisha Waya ni nini?
Uunganishaji wa waya ni mbinu ya muunganisho wa kielektroniki unaotumiwa kuunganisha vifaa vya semiconductor kwenye vifungashio vyake au substrates. Kama moja ya teknolojia muhimu zaidi katika tasnia ya semiconductor, inawezesha muingiliano wa chip na saketi za nje katika vifaa vya elektroniki.
Nyenzo za Waya za Kuunganisha
1. Alumini (Al)
Uendeshaji bora wa umeme dhidi ya dhahabu, wa gharama nafuu
2. Shaba (Cu)
25% ya juu ya conductivity ya umeme/mafuta kuliko Au
3. Dhahabu (Au)
Uendeshaji bora, upinzani wa kutu, na uaminifu wa kuunganisha
4. Fedha (Ag)
Conductivity ya juu kati ya metali
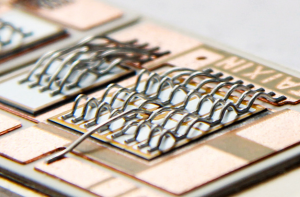
Waya ya Alumini

Utepe wa Alumini

Waya wa Shaba

Utepe wa Shaba
Semiconductor Die Bonding & Wire Bonding AOI
Hutumia kamera ya viwanda ya megapixel 25 kugundua kasoro za kiambatisho na waya kwenye bidhaa kama vile IC, IGBT, MOSFET na fremu za risasi, na hivyo kufikia kiwango cha kugundua kasoro kubwa zaidi ya 99.9%.

Kesi za Ukaguzi
Ina uwezo wa kukagua urefu wa chip na kujaa, kukabiliana na chip, kuinamisha, na kukatwa; mpira wa solder usio wa kujitoa na kikosi cha pamoja cha solder; hitilafu za kuunganisha waya ikiwa ni pamoja na urefu wa kitanzi kupindukia au usiotosha, kuanguka kwa kitanzi, nyaya zilizokatika, nyaya zinazokosekana, mguso wa waya, kupinda waya, kuvuka kitanzi, na urefu wa mkia kupita kiasi; adhesive haitoshi; na splatter ya chuma.
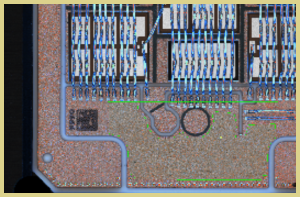
Solder Ball/ Mabaki

Chip Scratch

Uwekaji wa Chip, Vipimo, Njia za Tilt
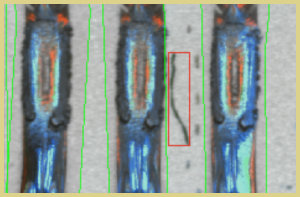
Uchafuzi wa Chip/ Nyenzo za Kigeni
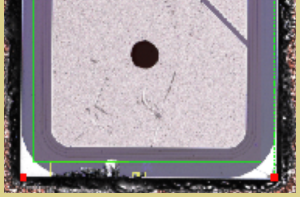
Chip Chipping
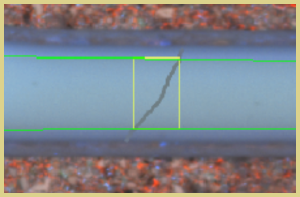
Nyufa za Mfereji wa Kauri

Uchafuzi wa Mfereji wa Kauri
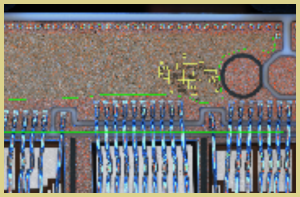
Oxidation ya AMB
Tanuri ya Utiririshaji wa Asidi ya Ndani ya Mstari

1. Kiwango cha juu cha halijoto ≥ 450°C,kiwango cha chini kabisa cha utupu <5 Pa
2. Inasaidia mazingira ya mchakato wa asidi ya fomu na nitrojeni
3. Kiwango cha utupu cha pointi moja ≦ 1%, kiwango cha jumla cha utupu ≦ 2%
4. Maji baridi + baridi ya nitrojeni, yenye mfumo wa baridi ya maji na baridi ya mawasiliano
Semicondukta ya Nguvu ya IGBT
Viwango vingi vya ubatilishaji katika uuzaji wa IGBT vinaweza kusababisha hitilafu za kukabiliana na mnyororo ikiwa ni pamoja na kukimbia kwa joto, kupasuka kwa mitambo na uharibifu wa utendaji wa umeme. Kupunguza viwango vya utupu hadi ≤1% huongeza kwa kiasi kikubwa utegemezi wa kifaa na ufanisi wa nishati.
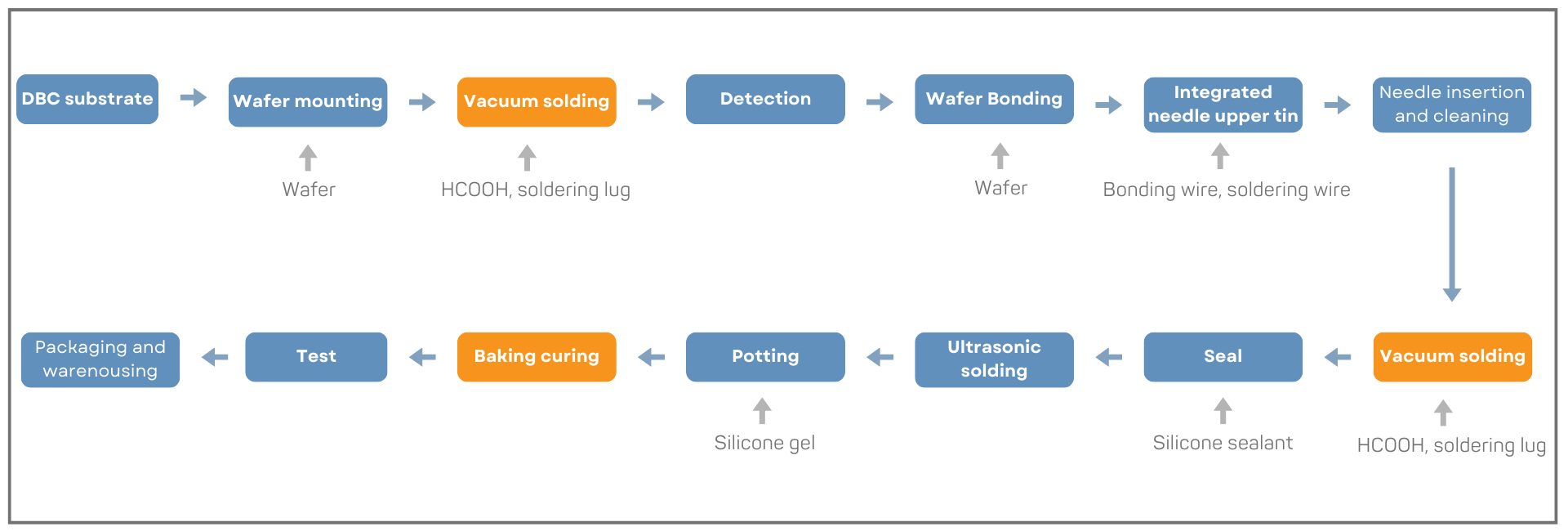
Chati ya mtiririko wa mchakato wa Uzalishaji wa IGBT








